联系我们
- 电话/微信:18520902353
- 客服QQ:3597831168
- 邮箱:info@wemaxnano.com
- 地址:广东省佛山市南海区狮山镇长兴西路12号建发风梅岭产业园9号楼
随着人工智能、物联网和高性能计算技术的飞速发展,半导体芯片的性能需求不断提升。然而,芯片小型化和高度集成化带来的散热问题,已成为制约高性能半导体发展的关键瓶颈。近期,一项发表在《Macromolecular Research》的研究提出了一种创新的解决方案:通过添加二氧化硅嵌入的碳纳米纤维(SiO₂/eCNFs),显著提升了环氧模塑料(EMC)的热导率和机械性能,为半导体封装的热管理开辟了新路径。
随着半导体集成度提高,芯片热生成量剧增,引发诸多性能和可靠性问题,如芯片内部输入 / 输出终端出现裂缝。目前虽有多种散热方法,像微流体冷却系统、相变材料应用、石墨烯基散热器使用以及在芯片基板中嵌入冷却通道等,但都存在局限性,例如微流体冷却系统结构复杂、成本高。
环氧模塑料(EMC)是半导体封装常用材料,由环氧树脂、填料和固化剂组成,其中填料占比大,对性能影响显著。二氧化硅(SiO₂)是常用填料,虽成本低、性能较好,但随着半导体性能要求提高,其在热性能方面已难以满足散热需求,寻找提升 EMC 热导率的方法迫在眉睫。
本文聚焦于 SiO₂嵌入碳纳米纤维(SiO₂/eCNFs)这一新型添加剂,旨在提升半导体封装用 EMC 的散热和机械性能。研究人员制备了三种尺寸的 SiO₂纳米颗粒,添加到聚丙烯腈(PAN)纳米纤维前驱体溶液中,经静电纺丝和碳化制得 SiO₂/eCNFs。将不同浓度(0.1 - 1.0 wt%)的 SiO₂/eCNFs 与 EMC 混合研究其影响。结果显示,添加 0.4 wt% 的 500SiO₂/eCNFs 的 EMC,热导率提升 67%,冲击强度提高 43%。红外相机观察发现,使用该材料封装的芯片表面温度上升更快,表明其在提升 EMC 散热性能上潜力巨大,有望成为下一代高性能半导体封装的关键添加剂。
研究团队首先通过Stöber法制备了三种不同尺寸(100 nm、300 nm和500 nm)的SiO₂纳米颗粒,并将其均匀分散在聚丙烯腈(PAN)前驱体溶液中。随后,通过电纺丝技术将PAN和SiO₂纳米颗粒纺制成纳米纤维,并在高温下进行碳化处理,最终制备出SiO₂/eCNFs(图1)。这一过程不仅保留了碳纳米纤维的一维结构,还成功将SiO₂纳米颗粒嵌入其中,为后续的热管理应用奠定了基础。
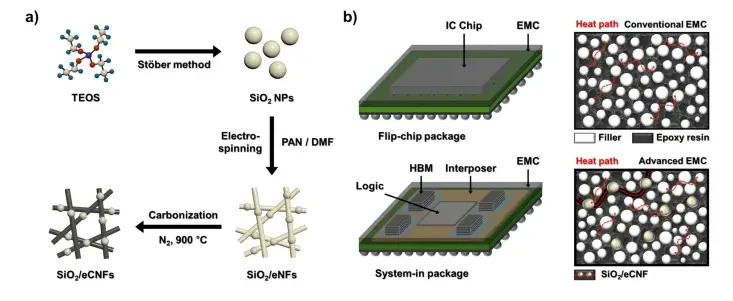
图1:a SiO 2 /eCNFs 材料合成路线示意图。b 传统电磁屏蔽材料封装的倒装芯片封装和先进电磁屏蔽材料封装的高带宽内存(HBM)之间散热要求的差异示意图。
接下来,研究者将制备好的SiO₂/eCNFs以不同浓度(0.1 wt%至1.0 wt%)添加到EMC中,并对其热性能和机械性能进行了系统评估。实验结果表明,当SiO₂/eCNFs的浓度为0.4 wt%时,EMC的热导率和冲击强度均达到最佳值(图2)。这一发现表明,适量的SiO₂/eCNFs能够显著改善EMC的性能,而过高浓度则会导致填料聚集,反而降低热导率。
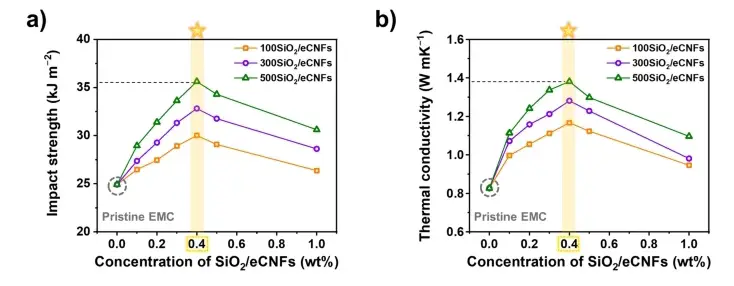
图2:不同浓度下SiO₂/eCNFs-EMC的热导率和冲击强度变化曲线,展示了0.4 wt%时的最佳性能。
为了深入理解SiO₂/eCNFs在EMC中的作用机制,研究者通过扫描电子显微镜(SEM)和光学显微镜(OM)对材料的微观结构进行了表征(图3)。结果显示,SiO₂/eCNFs能够成功嵌入EMC的填料之间,形成额外的热传导通道,同时与环氧树脂基体之间展现出良好的界面结合力。
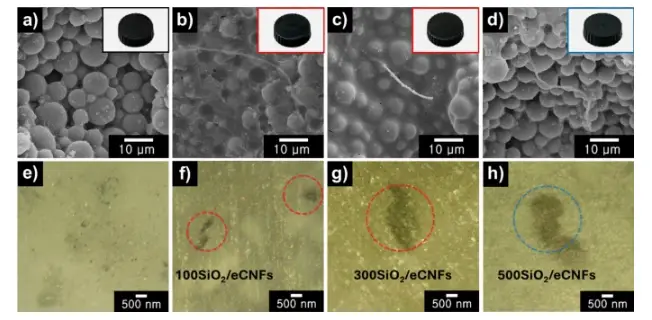
图3:SiO₂/eCNFs-EMC的截面SEM图像,展示了SiO₂/eCNFs在EMC中的分布及其与填料的连接情况。
此外,研究团队还利用红外相机对封装芯片的热性能进行了实际测试。实验中,将封装有SiO₂/eCNFs-EMC和传统EMC的芯片置于70°C的加热板上,观察其表面温度的变化(图4)。结果表明,使用SiO₂/eCNFs-EMC封装的芯片表面温度上升更快,且温度分布更加均匀,这进一步证实了其在热管理方面的优势。
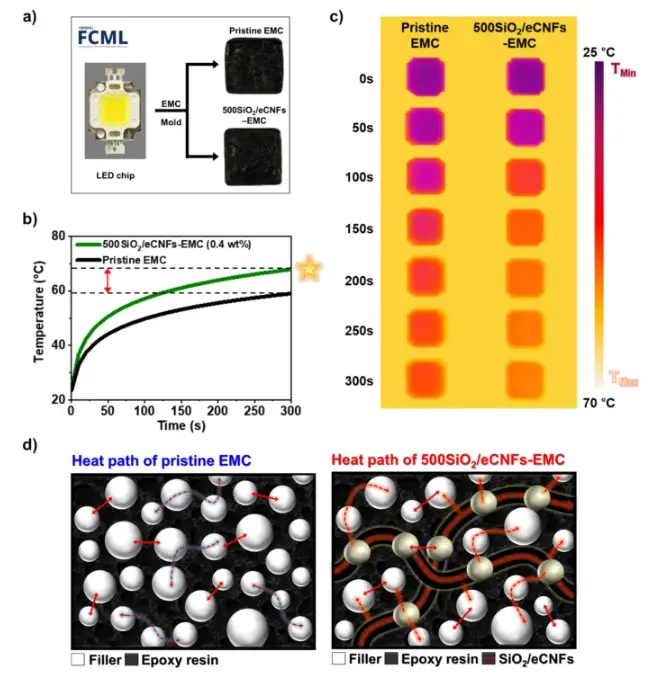
图4:封装芯片的红外热成像图,展示了SiO₂/eCNFs-EMC在实际应用中的热管理性能。
本研究的创新之处在于将一维碳纳米纤维与零维SiO₂纳米颗粒相结合,形成了一种新型的复合添加剂。这种结构不仅充分利用了碳纳米纤维的高热导率和一维优势,还通过嵌入的SiO₂纳米颗粒优化了与EMC填料的兼容性,从而显著提升了EMC的热导率和机械性能。此外,通过实验验证,这种新型EMC添加剂在实际芯片封装中展现出了优异的热管理性能,为高性能半导体封装领域提供了一种极具潜力的解决方案。
查阅链接:https://doi.org/10.1007/s13233-024-00317-y

联系客服二维码

纳米纤维及其应用